一文讀懂ALD原子層沉積技術
概述:
原子層沉積(Atomic layer deposition)是一種可以將物質以單原子膜形式一層一層的鍍在基底表面的方法。原子層沉積與普通的化學沉積有相似之處。但在原子層沉積過程中,新一層原子膜的化學反應是直接與之前一層相關聯的,這種方式使每次反應只沉積一層原子。
單原子層沉積(atomic layer deposition,ALD),又稱原子層沉積或原子層外延(atomic layer epitaxy) ,是一種基于有序、表面自飽和反應的化學氣相薄膜沉積技術。Z初是由芬蘭科學家提出并用于多晶熒光材料ZnS:Mn以及非晶Al2O3絕緣膜的研制,這些材料是用于平板顯示器。由于這一工藝涉及復雜的表面化學過程和低的沉積速度,直至上世紀80年代中后期該技術并沒有取得實質性的突破。
但是到了20世紀90年代中期,人們對這一技術的興趣在不斷加強,這主要是由于微電子和深亞微米芯片技術的發展要求器件和材料的尺寸不斷降低,而器件中的高寬比不斷增加,這樣所使用材料的厚度降低至幾個納米數量級。
因此,原子層沉積技術的優勢就體現出來,如單原子層逐次沉積,沉積層極均勻的厚度和優異的一致性等就體現出來,而沉積速度慢的問題就不重要了。以下主要討論原子層沉積原理和化學,原子層沉積與其他相關技術的比較,原子層沉積設備,原子層沉積的應用和原子層沉積技術的發展。
原子層沉積系統(ALD)的原理:
原子層沉積是通過將氣相前驅體脈沖交替地通入反應器并在沉積基體上化學吸附并反應而形成沉積膜的一種方法(技術)。當前驅體達到沉積基體表面,它們會在其表面化學吸附并發生表面反應。在前驅體脈沖之間需要用惰性氣體對原子層沉積反應器進行清洗。由此可知沉積反應前驅體物質能否在被沉積材料表面化學吸附是實現原子層沉積的關鍵。氣相物質在基體材料的表面吸附特征可以看出,任何氣相物質在材料表面都可以進行物理吸附,但是要實現在材料表面的化學吸附必須具有一定的活化能,因此能否實現原子層沉積,選擇合適的反應前驅體物質是很重要的。

圖1
基于原子層沉積的原理,利用原子層沉積制備高質量薄膜材料,三大要素必不可少:1)前驅體需滿足良好的揮發性、足夠的反應活性以及一定熱穩定性,前驅體不能對薄膜或襯底具有腐蝕或溶解作用(圖2 A);2)前驅體脈沖時間需保證單層飽和吸附(圖2 A);3)沉積溫度應保持在ALD窗口內,以避免因前驅體冷凝或熱分解等引發CVD生長從而使得薄膜不均勻(圖2 B)。

圖2
原子層沉積的表面反應具有自限制性(self-limiting),實際上這種自限制性特征正是原子層沉積技術的基礎。不斷重復這種自限制反應就形成所需要的薄膜。
原子層沉積的自限制特征 :根據沉積前驅體和基體材料的不同,原子層沉積有兩種不同的自限制機制,即化學吸附自限制(CS)和順次反應自限制(RS)過程。
化學吸附自限制沉積過程中,第一種反應前驅體輸入到基體材料表面并通過化學吸附(飽和吸附)保持在表面。當第二種前驅體通入反應器,起就會與已吸附于基體材料表面的第一前驅體發生反應。兩個前驅體之間會發生置換反應并產生相應的副產物,直到表面的第一前驅體完全消耗,反應會自動停止并形成需要的原子層。因此這是一種自限制過程,而且不斷重復這種反應形成薄膜。

圖3
與化學吸附自限制過程不同,順次反應自限制原子層沉積過程是通過活性前驅體物質與活性基體材料表面化學反應來驅動的。這樣得到的沉積薄膜是由于前驅體與基體材料間的化學反應形成的。圖a和b分別給出了這兩種自限制反應過程的示意圖。由圖可知,化學吸附自限制過程的是由吸附前驅體1(ML2)與前驅體2(AN2)直接反應生成MA原子層(薄膜構成),主要反應可以以方程式⑴表示。對于順次反應自限制過程首先是活化劑(AN)活化基體材料表面;然后注入的前驅體1(ML2)在活化的基體材料表面反應形成吸附中間體(AML),這可以用反應方程式⑵表示。反應⑵隨著活化劑AN的反應消耗而自動終止,具有自限制性。當沉積反應前驅體2(AN2)注入反應器后,就會與上述的吸附中間體反應并生成沉積原子層。
圖 A.化學吸附(CS)和B.順次反應(RS)自限制原子層沉積過程示意圖
ML2 + AN2 --- MA(film) + 2LN ⑴
AN + ML2 --- AML + NL ⑵
AML + AN2 --- MAN + NL ⑶
這里需要說明的是前軀體1能夠在基體材料表面快速形成穩定的化學吸附層是化學吸附自限制原子沉積過程的必要條件。對于順次反應自限制過程,一方面基體材料表面必須先經過表面活化,另一方面,這種沉積反應實際是半反應⑵和⑶的組合。每個半反應完成后材料表面的功能基團都會發生變化,并且一個原子層沉積完成時,材料表面要恢復到Z初的活化基團狀態。這種恢復特點以及材料表面原始活性狀態是區分上述兩種不同的自限制反應沉積過程的主要因素。
技術應用:
原子層沉積技術由于其沉積參數的高度可控型(厚度,成份和結構),優異的沉積均勻性和一致性使得其在微納電子和納米材料等領域具有廣泛的應用潛力。就已發表的相關論文和報告可預知,該技術可能應用的主要領域包括:
1) 晶體管柵極介電層(high-k)和金屬柵電極(metal gate)
2) 微電子機械系統(MEMS)
3) 光電子材料和器件
4) 集成電路互連線擴散阻擋層
5) 平板顯示器(有機光發射二極管材料,OLED)
6) 互連線勢壘層
7) 互連線銅電鍍沉積籽晶層(Seed layer)
8) DRAM、MRAM介電層
9) 嵌入式電容
10) 電磁記錄磁頭
11) 各類薄膜(<100nm)
原子層沉積技術沉積出的相關薄膜材料
材料類別 沉積材料
Ⅱ-Ⅵ化合物 ZnS,ZnSe,ZnTe,ZnS1-xSex,CaS,SrS,BaS,SrS1-xSex,CdS,CdTe,MnTe,HgTe,Hg1-xCdxTe,Cd1-xMnxTeⅡ-Ⅵ基TFEL磷光材料 ZnS:M (M=Mn,Tb,Tm),CaS:M (M=Eu,Ce,Tb,Pb),SrS:M (M=Ce,Tb,Pb,Mn,Cu)
Ⅲ-V化合物 GaAs,AlAs,AlP,InP,GaP,InAs,AlxGa1-xAs,GaxIn1-xAs,GaxIn1-xP
氮(碳)化物 半導體/介電材料 AlN,GaN,InN,SiNx
導體 TiN(C),TaN(C),Ta3N5,NbN(C),MoN(C)
氧化物 介電層 Al2O3,TiO2,ZrO2,HfO2,Ta2O5,Nb2O5,Y2O3,MgO,CeO2,SiO2,La2O3,SrTiO3,BaTiO3
透明導體/半導體 In2O3,In2O3:Sn,In2O3:F,In2O3:Zr,SnO2,SnO2:Sb,ZnO,ZnO:Al,Ga2O3,NiO,CoOx
超導材料 YB2Cu3O7-x
其他三元材料 LaCoO3,LaNiO3
氟化物 CaF,SrF,ZnF
單質材料 Si,Ge,Cu,Mo,Pt,W,Co,Fe,Ni,Ru
其他 La2S3,PbS,In2S3,CuGaS2,SiC
應用案例:晶體管材料制備方面的應用
原子層沉積技術憑借其獨特的表面化學生長原理、亞納米膜厚的精確控制性以及適合復雜三維高深寬比表面沉積等特點,特別適合這類薄膜材料的制備。例如:S.F. Bent等人利用十八烷基磷酸鹽(ODPA)對Cu的選擇性吸附(圖4),在預先吸附有ODPA分子的襯底表面進行ALD沉積Al2O3,有效避免了Al2O3在Cu表面沉積,從而得到被高k絕緣材料Al2O3所間隔的空間選擇性暴露表面Cu的優質薄膜材料。此外,電鏡照片(圖5)表明該沉積方法的區域選擇性得到了有效保證。
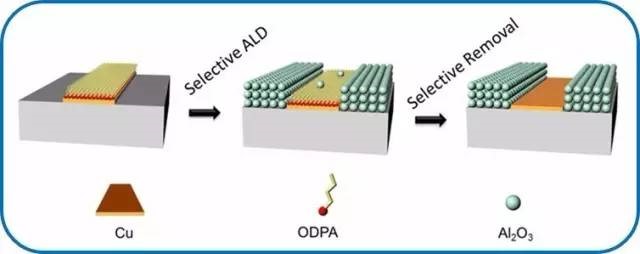
圖4. ALD區域選擇性沉積Al2O3原理

圖5.(a)(d)(g)圖案化的Cu/SiO2襯底SEM照片;(b)(e)(h)ODPA處理1 h經Al2O3ALD沉積后的Cu/SiO2襯底Al俄歇圖像;(c)(f)(i)沉積完經醋酸溶液中超聲10 min處理后的Cu/SiO2襯底Al俄歇圖像。
原子層沉積的優勢:
從原理上說,ALD是通過化學反應得到生成物,但在沉積反應原理、沉積反應條件的要求和沉積層的質量上都與傳統的CVD不同,在傳統CVD工藝過程中,化學蒸汽不斷通入真空室內,因此該沉積過程是連續的,沉積薄膜的厚度和溫度、壓力、氣體流量以及流動的均勻性、時間等多種因素有關;在ALD工藝過程中,則是將不同的反應前驅物以氣體脈沖的形式交替送入反應室中,因此并非一個連續的工藝過程。相對于傳統的沉積工藝而言,ALD在膜層的均勻性、階梯覆蓋率以及厚度控制等方面都具有明顯的優勢。
在某些應用中,需要在具有很大長徑比的內腔表面鍍膜,極限的情況下長徑比會達到15甚至20,采用傳統的鍍膜方法是無法實現的,而原子層沉積技術由于是通過在基底表面形成吸附層,進一步通過反應生成薄膜,因而在這方面具有獨特的優勢,可以在大長徑比的內腔表面形成厚度均勻的薄膜。

圖6.原子層沉積技術與其他制膜技術對比

圖7
原子層沉積技術的發展:等離子體增強原子層沉積(Plasma-Enhanced AtomicLayer Deposition,PEALD)
原子層沉積技術經過四十多年的發展,無論是在沉積材料的種類還是具體沉積方法的擴展與改進上,都已經取得了長足進步,在眾多領域更是展現出令人期待的商業前景。但傳統的熱原子層沉積技術在發展過程中仍面臨著一些挑戰。比如:原子層沉積前驅體往往都是金屬有機化合物,合適的前驅體種類較少而且價格昂貴;傳統熱原子層沉積技術因需要長時間的惰氣吹掃以保證隨后的表面自限制薄膜生長,沉積速率較慢,不適合大規模工業生產;此外,熱原子層沉積技術難以用來沉積金屬Ti,Ta等特殊材料。
隨著原子層沉積技術與其他先進技術不斷融合以及人們對原子層沉積設備的不斷改進,諸如“等離子體增強原子層沉積技術”、“空間式原子層沉積技術”、“流化床原子層沉積技術”等新型原子層沉積技術逐漸出現并在一定程度上有效解決了傳統熱原子層沉積技術所面臨的諸多難題。下面主要介紹等離子體增強原子層沉積技術(PEALD)
1991年,荷蘭科學家deKeijser和van OpdorpS次使用氫氣等離子體與三甲基鎵和砷化氫反應外延生長砷化鎵,進而提出了等離子體增強原子層沉積技術。
在過去二十多年,等離子體增強原子層沉積技術發展迅速。通過巧妙設計等離子體引入方式,人們已經設計出如圖8所示各種等離子體增強原子層沉積設備。

圖8.(A)直接等離子體增強原子層沉積;(B)遠程等離子體增強原子層沉積;(C)自由基增強原子層沉積。

圖9.(A)等離子體增強原子層沉積與熱原子層沉積原理圖對比;(B)不同襯底和沉積材料對應的沉積溫度范圍;(C)利用不同原子層沉積技術在Si (111) 表面生長AlN時,初始階段膜厚隨ALD循環次數變化(插圖為溝道結構Si襯底表面采用N2-H2 PEALD技術沉積AlN SEM截面圖)。
如圖9A,與熱ALD相似,PEALD的每一循環也由前驅體A脈沖吸附、惰氣吹掃、前驅體B脈沖吸附、惰氣吹掃四步組成,但與熱ALD不同之處在于,PEALD采用了含有各種高活性粒子(如:含有O2、O、O2*、O*、O2+、O+、O-等活性物種的O2等離子體)的等離子體B*來代替前驅體B與吸附于襯底表面的前驅體A反應。高活性物種的引入不僅在很大程度上提高了原子層沉積的速率,而且還避免了熱ALD中的延遲成核現象的發生(圖9C),從而改善了薄膜質量。此外,采用PEALD還可以拓寬前驅體種類和ALD溫度窗口(圖9B),使得生物材料和聚合物材料等溫度敏感型襯底表面的沉積以及需要高溫活化的前驅體物質的沉積成為可能,從而使原子層沉積技術能應用于更多的領域。
以聚合物表面沉積貴金屬Ru為例(圖10),使用RuO4為前驅體與H2進行熱ALD沉積金屬Ru薄膜時,RuO4在100度以上即發生熱分解,引發類CVD生長,不利于膜厚控制和三維共形生長。當沉積溫度降至50度時,測量發現,薄膜生長緩慢。75度薄膜生長明顯,但XPS測試顯示所得金屬Ru薄膜中含有大量O,這與低溫下H2活性不足密切相關,從而極大降低了薄膜的導電性能。因此,傳統熱ALD用于沉積金屬Ru只在100度附近存在一個較窄的沉積窗口。當使用等離子體H2代替普通H2后,在50至100度范圍均能進行Ru薄膜的快速生長,XPS測試也顯示薄膜含氧量較低。由此可以看出等離子體技術的引入可以在一定程度上解決目前熱原子層沉積所面臨的困難。
目前,等離子體增強原子層沉積不僅能夠在更溫和條件下沉積傳統熱原子層沉積能夠沉積的一些金屬以及氧化物等薄膜材料,還可以沉積通常采用CVD在高溫條件下才能沉積的石墨烯等新興材料。
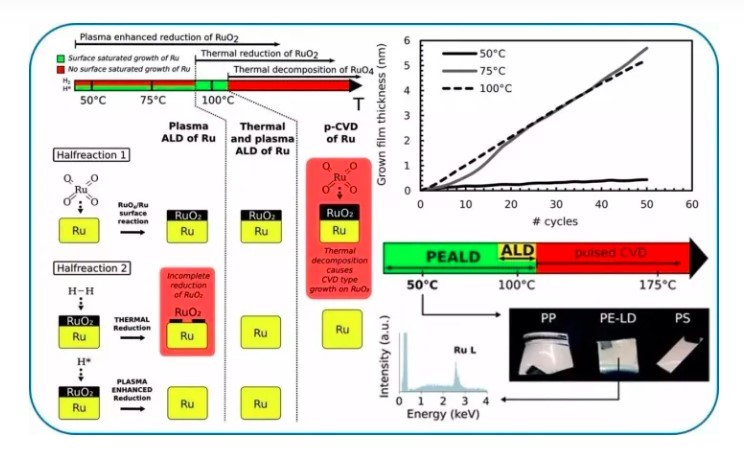
圖10. 采用ALD、PEALD生長金屬Ru的特點
ps:技術文章為資源整理而成,供大家技術交流使用,如有涉及版權,請與我們聯系刪除,謝謝!
相關產品
全部評論(0條)
推薦閱讀
-

- 電池熱失控危機如何化解?Forge Nano ALD 原子層沉積揭示答案!
- Forge Nano 的 Atomic ArmorTM 涂層使電池制造商能夠使用更高能量的材料來制造電池,而不必擔心增加熱失控事件,這應該會減少較大電池組中的熱傳導。
-

- 納米粒子表面工程新突破:原子層刻蝕調控 ALD 包覆顆粒殼層厚度
- 科羅拉多大學(Forge Nano 粉末原子層沉積技術發源地)Steven George 等人使用自行搭建的旋轉床粉末原子層沉積設備和原子層刻蝕(ALE)技術精確控制了 TiO/ZrO核殼納米粒子中
-

- 一文讀懂工頻介電常數測試儀
- 工頻介電常數測試儀
-

- 一文讀懂工頻介電常數測試儀
- 在電氣和材料研究領域,有一個儀器雖然不常被大眾提起,但卻至關重要,它就是工頻介電常數測試儀。這個儀器能幫助我們了解材料在電場中的 “脾氣秉性”,無論是電子產品、電力設備,還是新能源材料,都離不開它的檢
-

- 原子層沉積賦能無鈷 LiNiO? 正極材料,引領全固態鋰電池性能革新!
- 本研究報道了一種基于無鈷 LiNiO?(LNO)正極材料的高能量全固態鋰電池(ASSLBs),通過高壓 O? 合成和原子層沉積(ALD)技術制備了一層獨特的超薄 LixAlyZnzOδ(LAZO)保護
-
- 功率半導體 | 一文讀懂功率半導體
- 實現“電力”轉換
-
- 一文讀懂:如何查看核酸合成儀圖譜
- 一文讀懂:如何查看核酸合成儀圖譜
-

- 一文讀懂美國FDA食品接觸材料檢測
- 經常有客戶問:美國FDA食品級接觸材料檢測測試檢測哪些項目呢,費用是多少呢?今天精準通檢測就給大家分享一下美國FDA食品級接觸材料檢測有哪些項目:
①本文由儀器網入駐的作者或注冊的會員撰寫并發布,觀點僅代表作者本人,不代表儀器網立場。若內容侵犯到您的合法權益,請及時告訴,我們立即通知作者,并馬上刪除。
②凡本網注明"來源:儀器網"的所有作品,版權均屬于儀器網,轉載時須經本網同意,并請注明儀器網(www.yosen.net.cn)。
③本網轉載并注明來源的作品,目的在于傳遞更多信息,并不代表本網贊同其觀點或證實其內容的真實性,不承擔此類作品侵權行為的直接責任及連帶責任。其他媒體、網站或個人從本網轉載時,必須保留本網注明的作品來源,并自負版權等法律責任。
④若本站內容侵犯到您的合法權益,請及時告訴,我們馬上修改或刪除。郵箱:hezou_yiqi
最新話題
最新文章
- 手套箱安全紅線清單:每一條都是“救命符”!
- 凸輪振動平臺的優缺點
- 3D數碼顯微鏡在鋰電池檢測中的應用分析 技術特點與設備比較
- 3D數碼超景深顯微鏡在儲能行業的技術應用與特點分析
- 廣皓天180 度折 FPC 折彎機助力深圳大學 共建柔性電子折彎技術產學研基地
- 廣皓天180 度折 FPC 折彎機 助力大眾汽車開發儀表盤多曲率 FPC 一次性成型
- 廣皓天180 度折 FPC 折彎機,助力某電子企業優化智能手機 FPC 可靠性
- 技術改進提升穩定性,廣皓天180 度折 FPC 折彎機更可靠
- 在 5G 通信設備制造中廣泛應用,廣皓天180 度折 FPC 折彎機大顯身手
- 鹽霧試驗箱在汽車行業的應用:從零部件到整車的防護驗證
作者榜





























參與評論
登錄后參與評論